
中国研究团队发布柔性可拉伸封装技术领域原创性成果
近日,上海交通大学材料科学与工程学院邓涛教授和尚文副研究员课题组联合美国北卡罗来纳州立大学Michael D. Dickey教授课题组和A123系统研发中心的王浚博士历经3年多的合作努力,在柔性封装材料与技术领域取得了重要突破
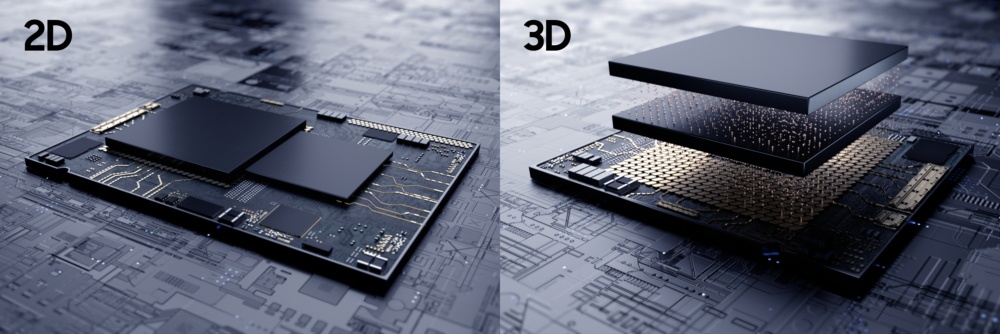
台积电与日本Ibiden等20家公司合作先进封装技术
据日韩媒体最近报导,台积电决定在日本投资,其中日本封装基板第一大公司 Ibiden扮演关键角色。 由于,半导体3D封装以及微制造技术的竞争正在升温,吸引越来越多的公司增加在封装领域的投资或进行合作。据说,封装能力将决定半导体公司 10 年后在产业的排名,而且摩尔定律延续就依赖3D封装技术。
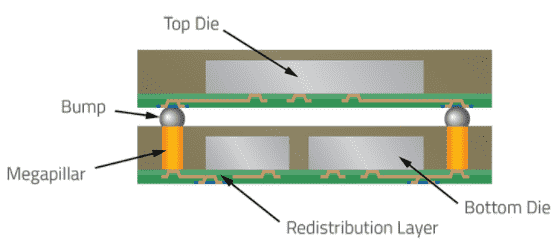
可实现扇出型晶圆级封装的铜电镀技术
高密度扇出型封装(FOWLP)技术由于能满足手机封装所需的外形尺寸和效能要求,逐渐获得业界关注。相较于通过微缩来实现摩尔定律的其他技术,FOWLP可提供更高整合度和更佳经济效益;本文在此前提下提出一种经济有效的晶粒堆叠方法——Durendal制造,以期实现理想的良率以及坚固、可靠的连接…



